GaN器件的反射率热成像与热特性表征,突破红外与拉曼光谱成像局限
日期:2025-08-22
随着先进微波器件尺寸不断缩小、结构复杂度增加,想要在亚微米尺度上全面理解其热行为变得愈发具有挑战性。而准确预测器件的瞬态和稳态热行为,对于确保其性能与可靠性至关重要。
与传统Si和GaAs器件相比,GaN等宽禁带半导体在热特性表征上面临独特挑战。
GaN器件热表征挑战
宽禁带导致的透明效应和薄膜干涉会使红外热成像、显微拉曼光谱成像和反射率热成像技术(Thermoreflectance,TR)等光学技术产生测量误差,例如红外辐射可能来自器件深部或被金属背电极反射,从而影响准确性。显微拉曼光谱成像在空间分辨率上优于红外,但在带有金属场板的器件中受限严重,且高功率激光存在损伤风险。
相比之下,反射率热成像方法通过逐点像素校准光强与温度关系,结合紫外光照明(<370 nm)避免GaN/SiC透射与薄膜干涉,能够在亚微米尺度上获得清晰的温度分布,分辨率可达约260nm。因而,反射率热成像为GaN器件的高精度热表征提供了一种兼具高空间分辨率与较强适用性的解决方案。
Microsanj公司和普渡大学的一项研究提出利用紫外波段下的反射率热成像直接测量GaN表面温度的方法,并通过电学法进行验证,同时比较了紫外和可见光激励下GaN HEMT器件场板与沟道的温度分布,展示了反射率热成像技术在GaN器件热表征中的应用优势。
通过电学法验证TR测试结果的准确性
为了验证使用紫外光进行TR测试的测试效果,研究人员选用了一个长18 µm、宽11 µm的GaN测试电阻(GaN mesa resistor)。在加热台上对器件加热来标定温度曲线,并采用四线法测量电阻随温度的变化。
TR测试使用365 nm LED光源和一个60X/0.7NA紫外波段物镜。为消除循环过程中热膨胀的影响,TR测量通过具有XYZ压电控制的加热台进行校准。实验证明,在365 nm波长下,GaN的反射率热成像材料系数约为 1.75 × 10⁻³ ℃⁻¹,比一般系数大约高出10倍,温度灵敏度提升到 5–10 mK。实验结果显示,电阻法与反射率热成像法的测量误差在 0.9%以内;进一步结合建模结果,三者的一致性在 1%以内。
未来的改进包括可以采用 340 nm光源,使其进一步远离GaN带隙边缘,从而减少宽带LED中紫外透射带来的干扰;另外,还可以使用 370 nm以上的滤光片,以滤除那些能够透过GaN和SiC的长波成分。
.png)
图1: 在三种不同功率条件下,Modeling, Resistance, Thermoreflectance的temperature sense resistor(TSR)的平均温度曲线对比图
未钝化的GaN/Si HEMT 紫外/可见光对比实验
为了进一步评估紫外波段反射率热成像在GaN HEMT中的应用,研究人员在一颗未钝化的2×45 μm GaN/Si HEMT上进行了紫外/可见光对比实验。取消钝化层的目的是减小薄膜干涉的影响。实验通过标定提取了 365 nm、470 nm和530 nm三种波长下的反射率热成像系数。在温度上升100 ℃的条件下,三者的系数分别为 -7×10⁻⁴℃⁻¹、1.75×10⁻⁴℃⁻¹ 和 -2×10⁻⁴℃⁻¹。所有波长实验均使用 50X/0.5NA物镜;对于紫外反射率热成像,还在LED光路中加入了 365 nm带通滤光片。
TR测试过程中,通过瞬态测试评估器件的瞬态热特性。实验中,器件以 50 μs脉冲、25%占空比的方式驱动,外加 20 V漏极偏置和负栅偏置,实现 1.6 W/mm的峰值功耗。测量每隔 5 μs进行一次,LED脉冲宽度从 650 ns(可见光TR测试)到 2.5 μs(紫外TR测试) 不等。
图a和b分别展示了530 nm可见光和365 nm UV光源下获得的热成像结果。由于器件没有场板,可以直接对比栅极金属与GaN区域的温度。实验提取了栅极金属宽度方向的线扫描温度曲线(可见光波长下),并与栅极与漏极之间GaN区域的温升做对比(见图c)。结果显示,470 nm与530 nm的温度曲线在栅极金属区域高度一致,验证了测量结果的准确性。
.png)
.png)
图2:GaN/Si HEMT的反射率热成像结果:a) 530 nm激励光源下栅极金属区域的温升;b) 365 nm激励光源下GaN沟道区域的温升;c) 沿栅极宽度方向的温升曲线,对比可见光与紫外光源下的结果。
对于紫外光下的反射率热成像,GaN区域的温升量级与栅极金属相当,但其温度分布表现出更加抛物线形的曲线。具体来说,GaN区域从中心到边缘的温差约为 10 ℃,而栅极金属中的温度梯度仅约为 5 ℃。这种差异是因为GaN内部的热扩散效应,而栅极金属由于几何结构限制,并不会发生同样的热扩散。
365nm UV与530nm可见光测试结果对比
随后,研究人员测试一个商业化的 0.25 µm GaN/SiC HEMT,使用紫外光在GaN沟道侧进行测量,使用530 nm可见光在场板顶部进行测量,并将测试结果进行对比。图3给出了不同波长光源下探测区域的示意图。
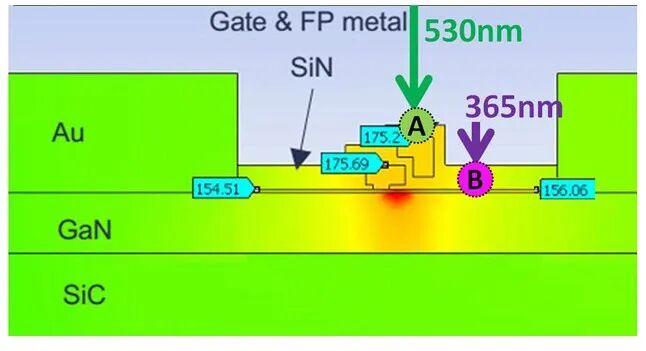
图3:A) 场板顶部;B) GaN沟道
如图4所示,利用 530 nm光源在场板顶部进行的可见光反射率热成像能够获得清晰的金属反射信号。这一测量点可为热模型提供精确的校准参考,从而有助于确定热点温度。在 100X/0.8NA物镜下,根据Rayleigh Criterion,分辨率为 0.40 µm, NT210B反射率热成像系统在100X下的像素分辨率为 45 nm/像素。
图4下半部分展示了使用紫外波长在场板一侧的GaN沟道内部进行TR测试的结果。由于场板与栅极边缘的遮挡,漏极–栅极边缘的热点无法直接探测,因此温度测量位置必须选在距离其数百纳米的区域。在 60X/0.7NA物镜下,系统分辨率为 0.32 µm,像素分辨率为 75 nm/像素。
.png)
图4:a) GaN/SiC HEMT 530 nm可见光与365 nm UV TR热成像结果;b) 热成像图叠加在CCD图像上;c) 热成像图可以通过调节比例尺突出发热位置。
总结
紫外光源下的反射率热成像测量结果与 GaN mesa resistor电学法测试结果高度一致,误差仅为 0.9%。进一步在有源GaN HEMT上的实验表明,无论是在金属场板顶部还是在 GaN沟道一侧,测试结果相符。
然而,由于GaN沟道内部存在陡峭的温度梯度,导致沟道区域的测量值往往低于漏极–栅极边缘的真实温度。尽管如此,发热区域与栅极/场板区域之间的紧密热耦合,这些位置仍然是可靠的测量点。
.png)
关于上海坤道
上海坤道信息技术有限公司成立于2009年,前身为英国Flomerics公司中国代表处,现为西门子工业软件(原Mentor Graphics公司)在中国大陆的授权金牌和专家级(Expert Partner)合作伙伴。一直以来,坤道专注于热仿真和热测试领域,为电子半导体、汽车、航天航空等行业提供Simcenter FloEFD、Flotherm Flexx、Flomaster等流体传热仿真软件解决方案和Simcenter T3STER热阻测试、Simcenter POWERTESTER功率循环测试、SanjSCOPETM 反射率热成像系统等硬件解决方案,具备资深专业、经验丰富的技术团队提供产品销售、项目咨询、硬件定制开发和技术培训等服务。目前,坤道公司已为400多家企业与机构提供热仿真&热测试解决方案和应用实践落地。
欢迎关注 上海坤道 SimuCAD 公众号,我们将为您带来最新产品资讯和专业的解决方案。
.jpg)
联系我们:
电话:021-62157100
邮箱:marketing@simu-cad.com
官网:http://www.simu-cad.com
哔哩哔哩:上海坤道SIMUCAD








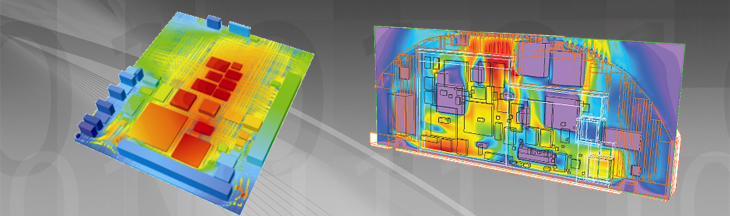

 沪公网安备 31010602003953号
沪公网安备 31010602003953号