结构函数— 热测量与热仿真之间的桥梁
日期:2015-08-13 Tags:结构函数
传统上,电子元器件的热测试是通过热电偶完成的。然而,使用热电偶存在的一些严重缺陷(例如被测器件与探针之间的接触热阻使得测量得到的结果极不稳定,并且热电偶还具有将热量传离被测器件表面的趋势)导致它们在测量塑料封装的表面温度时几乎毫无用处。
当前,在产品设计阶段,通过确认热学界面材料 (TIM) 层的材料属性和厚度来验证热学模型,以确保产品实现设计性能的需求日益增多。使用热电偶的主要问题在于,它们根本无法测量内部结构的温度。而依据设计,主要的热流路径是从结点开始,经过多种材料和材料界面,最后传递到 PCB 或散热器中,PCB 或散热器的温度可以方便的测量。即便在这种情况下,热电偶仍旧只能提供单一温度数值。因此在涉及到热设计验证时,热电偶作为一个“感觉迟钝的仪器”就完全派不上用场。
在本文中,我们将介绍热学结构分析方法,该方法基于瞬态热测试技术,可将系统的热特性(包括热扩散)表征为分布式热阻-热容 (RC) 网络。通过测量结点的瞬态响应,我们可以容易地观察封装、电路板、TIM 和散热器等内部的热流扩散路径。
1真实世界中热分析面临的挑战
研究热学结构的最佳方式是查看沿热流扩散路径的等温线分布或热通量分布。然而,在真实世界中,拍摄任何固体物体内部的热分布照片是不可能的。使用本文中所用的 FloTHERM™ 等仿真软件是查看热通量分布的唯一方法。根据理论 [1],热学系统为分布式 RC 系统,可根据热阻 Rth 和热容 Cth 为其建模。要评估 RC 系统,最常用的方法是测量阶跃功率激励下的瞬态响应。
思考图 1 中的实验设置。理想的隔热材料可防止热量向 Y 和 Z 方向逸散,而位于 X 轴右侧的冷板则可提供理想的热学边界条件。在此设置中,热通量将被限制在 X 轴,可视为沿 X 轴从左侧热源到右侧冷板的一维热扩散路径。
.jpg)
热学扩散路径上的 Rth 和 Cth 热特性,决定了系统的阶跃功率的响应。理论上,我们可根据 1995 颁布的 JEDEC JESD 51-1 标准中规定的电学测试方法测量瞬态热响应,来对热学结构进行评估。
在实验中,我们将三种作为标志的材料放在热流路径的中间。
1. 与纯铜相同。(Cu50W)
2. 双倍于纯铜的比热容
(Cu50W_2xCth)
3. 一半于铜的热导率。
(Cu50W_2xRth)
图 2 绘制了阶跃功率响应与结构函数。在温度响应视图中,可以观察到不同标志材料所导致的差异,可是不够清晰,而在结构函数视图中,则可以清晰地辨别结构性的信息(如图 3 所示)。
.jpg)
.jpg)
2更贴近真实 PCB 电路板应用的案例分析
真实世界中的案例,(例如安装在 PCB 电路板上的封装),如图 4 所示,热扩散不仅发生在垂直方向上,还发生在水平方向上。
.jpg)
热源(硅芯片)被粘贴在金属(铜)基板上,然后再固定到 FR4 电路板上。为简单起见,将每种材料构造为一个立方体,并且不考虑接触热阻。
在结构函数中,在初始部分可以看到 0 ~ 0.4 K/W 区间的直线部分。此直线源自芯片内部近乎一维的热流(如图 5 所示)。这是因为硅芯片外部的空气相对于硅具有大得多的热阻,因此,正如我们在前一部分讨论的那样,热量被迫沿硅的厚度扩散。在超过 0.4K/W 后,结构函数曲线呈指数级上升,这是由于金属基板中的三维热扩散所致(如图 6 所示)。
.jpg)
.jpg)
同理,0.8K/W ~ 1.2 K/W 区间的结构函数还表明了铜块中的热扩散,并且结构函数曲线呈现不断增大的斜率。在 1.2K/W 之后,我们观察到曲线斜率开始下降。这是由于金属基板的物理边界所致。
3结论
传统上,在进行热分析时,CFD 仿真软件中构建的热模型包含成千上万条数据。用户面临的挑战是如何验证模型的正确性。由于结构函数可通过实验和仿真方法获取,因此我们现在能够通过比较封装热学模型与真实封装的结构函数,来根据真实封装数据验证封装热学模型。如果存在任何不匹配,使用封装模型,我们可以容易地识别和解决问题,从而提高了任何电路板级别或系统级模型的精确度 [2]。由于结构函数可跟踪从芯片结点到最终环境的热流路径,因此也可在后期设计中将该技术应用于电路板级别和系统级模型,在将电子产品投入批量生产之前对其进行确认。
注释
本文章编辑自《Transactions on The Japan Institute of Electronics Packaging》第 5 卷第 1 号(2012 年 12 月)中发布的论文。
参考文献
[1] V. Székely 和 T.Van Bien,“Fine structure of heat flow path in semiconductor devices: a measurement and identification method”,《Solid- State Electron.》第 31 卷,第 1363-1368 页,1988 年。
[2] András Vass-Varnai、Robin Bornoff 等,“Thermal Simulations and Measurements - a Combined Approach for Package Characterization”,2011 年度 ICEP,日本。
[3] Yafei luo,“Structure function based thermal resistance & thermal capacitance measurement for electronic system”。CPMT 日本研讨会,2010 年度 IEEE。








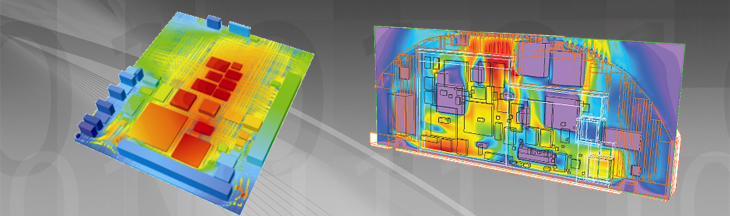

 沪公网安备 31010602003953号
沪公网安备 31010602003953号