一. 产品概述
SanjSCOPE™高空间分辨率高时间分辨率热成像系统主要采用基于lock-in手段的反射率热成像技术,结合数字信号处理手段以及先进的软件算法,为用户提供一个集高空间分辨率、高时间分辨率的,可以对亚微米级别的微电子系统进行热分析的通用工具。
• 高空间分辨率:根据衍射极限,SanjSCOPETM产品的空间分辨率可以高达 300 纳米左右,特别适用于目前微电子行业在微型化、高集成度化下的新型半导体器件的温度表征。
• SanjSCOPE™产品使用了 lock-in 技术来增强测试信噪比,温度灵敏度典型值100mK~250mK。
• SanjSCOPE™产品配备了高性能压电式样品台及控制器,该压电式样品台具备 x, y, z 三轴的自动定位功能,可以用于补偿由于热胀冷缩引起的样品位移和失焦现象,且定位分辨率高达 1nm。
• SanjSCOPE™产品的反射率热成像技术不仅能够测试半导体材料,还能够测试金属材料。
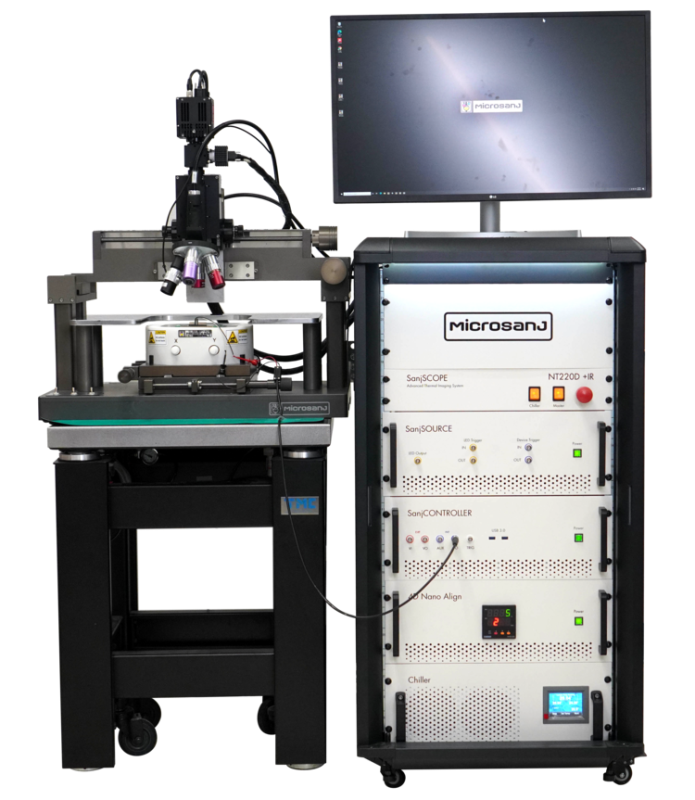
查看详细介绍请点击此处下载 SanjSCOPE热成像系统-产品介绍资料
SanjSCOPE热成像系统-产品介绍资料
二. SanjSCOPE™的典型应用
|
SanjSCOPE 可以应用于以下场景的热分析:
• 热点探测;
• GaN,GaAs,SiC,以及其他宽禁带材料 的半导体器件;
• 具有多层结构的高级封装器件;
• InP,Si材料的光电子器件;
• IGBT器件;
• 闩锁效应;
• 倒装焊芯片 Flip Chip; |
SanjSCOPE可以帮助您:
• 开发并确认器件的热模型;
• 评估器件加工过程的一致性;
• 优化器件的热性能;
• 探测器件的瞬变热行为;
• 失效分析;
|
应用行业: 通信、汽车电子、国防电子、物联网、光电子以及其他各种新兴应用
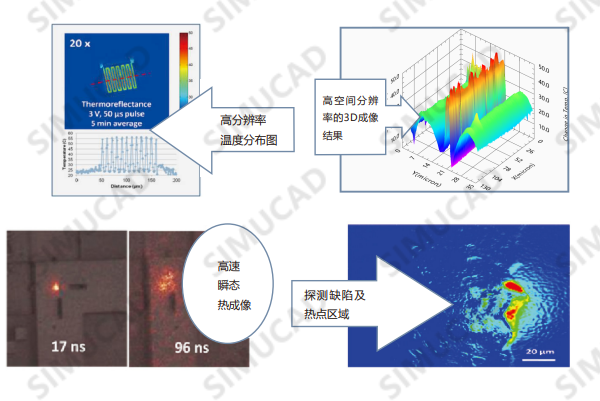
三. 测试原理
反射率热成像技术(Thermoreflectance)
材料的反射率与温度有关,因此可以通过测试器件表面的反射光强度的改变得到其温度的改变。

使用脉冲光源照射到样品表面,并通过探测样品表面由于施加激励后引起的反射率变化,通过提前标定的CTR 值即可获得温度变化。
• 空间分辨率:300nm~400nm(取决于光源波长,物镜的数值孔径等);
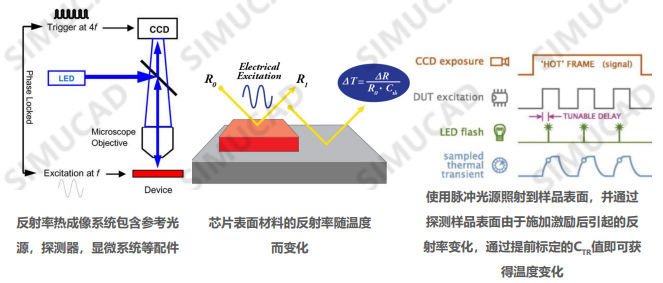
四. 产品信息
|
EZ-THERM™-Series 灵活的台式热成像系统 |
NanoTherm-Series 纳秒级瞬态热成像系统 |
|
EZ500/EZ510/ EZ100-SYS |
NT220 |
|
主要性能指标:
* 瞬态时间分辨率:50us(EZ500), 5us (EZ510); * 支持 IR单模式系统(EZ100-SYS)和 TR+IR双模式系统(EZ500/EZ510); * 轻便的,灵活的台式热成像系统; * 模块化配置,可分批购买需要的模块; * 支持和客户现有的半导体设备连接使用(探针台,光学显微系统等)。 |
主要性能指标:
* 瞬态时间分辨率:50ns(可升级为 500ps); * 支持 TR + IR的双模式,最多支持 3个传感器; * 受市场认可的专业级别的热成像系统; * 瞬态时间分辨率最快的商业化热成像系统; * 可配置的产品架构,方便用户选择适合自己应用的配置。
|
SanjSCOPE™ NT220
SanjSCOPETM NT220系统模块图
SanjSCOPE™ NT220 电子控制部分

SanjSCOPE™ NT220 光学部分
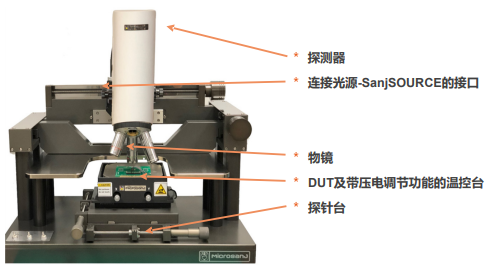
查看详细介绍请点击此处下载 SanjSCOPE热成像系统-产品介绍资料
SanjSCOPE热成像系统-产品介绍资料
1、GaN HEMT研究
GaN HEMT的栅长是纳米量级的,通过传统的热成像手段很难获得栅极金属的温度分布。
A、 凭借SanjSCOPETM热成像系统优异的空间分辨率,以及金属强烈的反射信号,用户可以获得栅极金属的温度分布。
B、 由于GaN材料对可见光透明,因此SanjSCOPETM热成像系统支持用户升级紫外方案,对GaN器件的温度分布进行完整而准确的表征
UV 波段 ( 波长<375nm) 是用于对GaN 材料进行反射率热成像测试的理想光源 (~20%反射, 无透射)
530nm (绿光) 是用于对金材料进行反射率热成像测试的理想光源
.png)
(1) Cree 的GaN HEMT 样品测试结果
A、测试装置
.png)
.png)
B、测试条件
1、偏置条件:28V, 500mA
2、加热时间:>30s
3、基板温度:70C
4、测试条件:
(1)530nm光源, 5X 物镜
(2)UV光源,5X物镜
(3)UV光源,20X物镜
(4)UV光源,60X物镜
(5)530nm光源,100X物镜
C、标定反射率-温度系数
.png)
.png)
.png)
.png)
D、稳态测试结果
.png)
D1、使用UV参考光源,在不同放大倍数下的结果比较
.png)
D2、使用可见光光源,在5X物镜下的稳态测试结果
.png)
D3、使用UV( 365nm )光源,在5X物镜下的稳态测试结果
.png)
D4、使用UV光源,在60X物镜下的稳态测试结果
.png)
.png)
D5、使用530nm光源,在100x物镜下的稳态测试结果
.png)
UV,60X与530nm,100x稳态结果对比
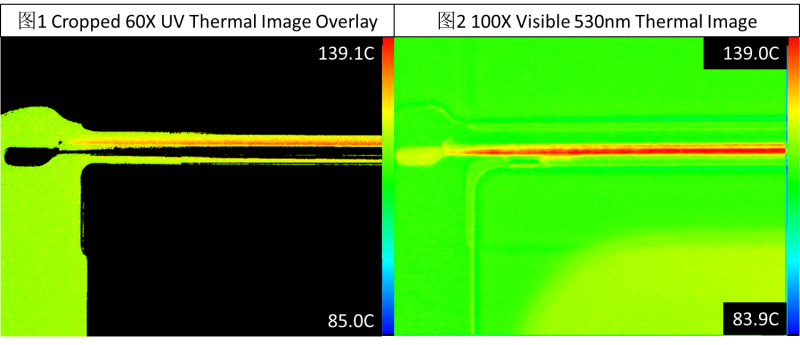
E、瞬态测试结果
E1、加热曲线
.png)
(2)、英国SURREY大学使用SanjSCOPETM设备+RF源测试GaN器件
.png)
.png) 、
、
.png)

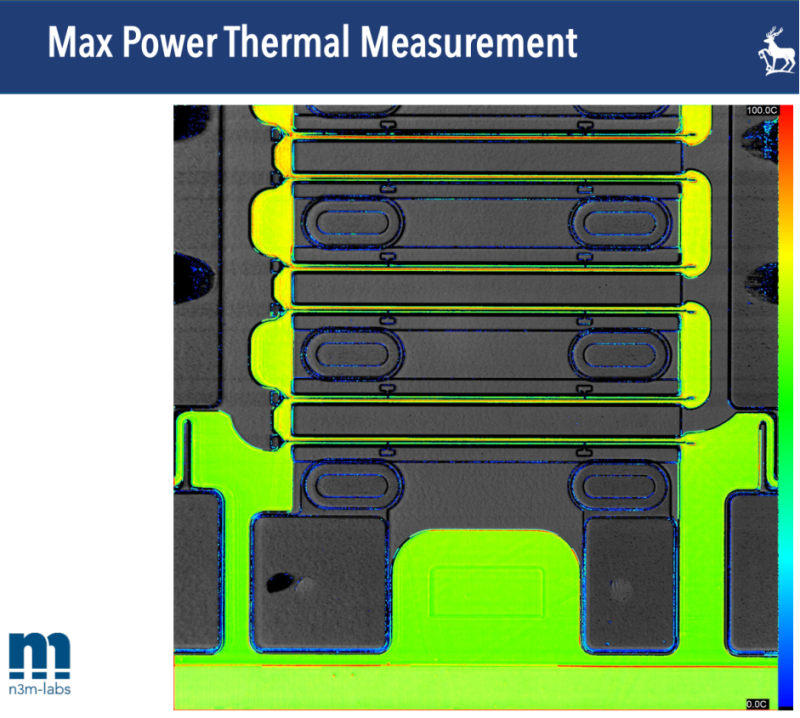
(3)、GaN HEMT瞬态测试结果
A、对GaN HEMT施加5us加热脉冲后的瞬态响应
.png)
B、使用瞬态温度响应曲线研究使用SiC衬底与金刚石衬底的性能对比。时间分辨率:50ns
.png)
C、GaN HEMT沟道超快速瞬态过程记录

2、GaAs MMIC
某GaAs MMIC在20X镜头下
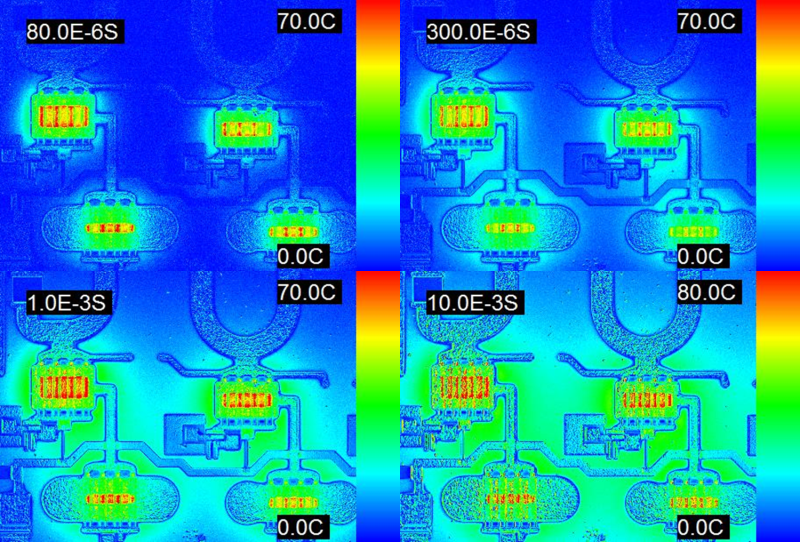

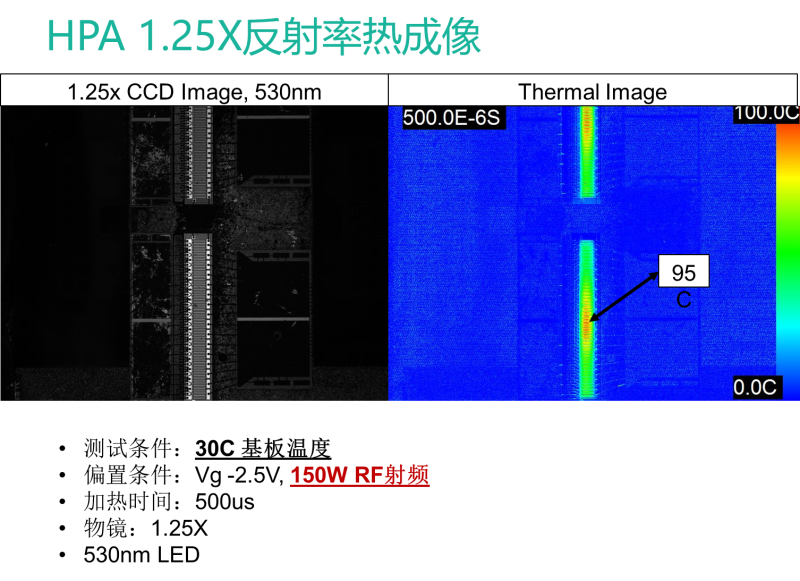
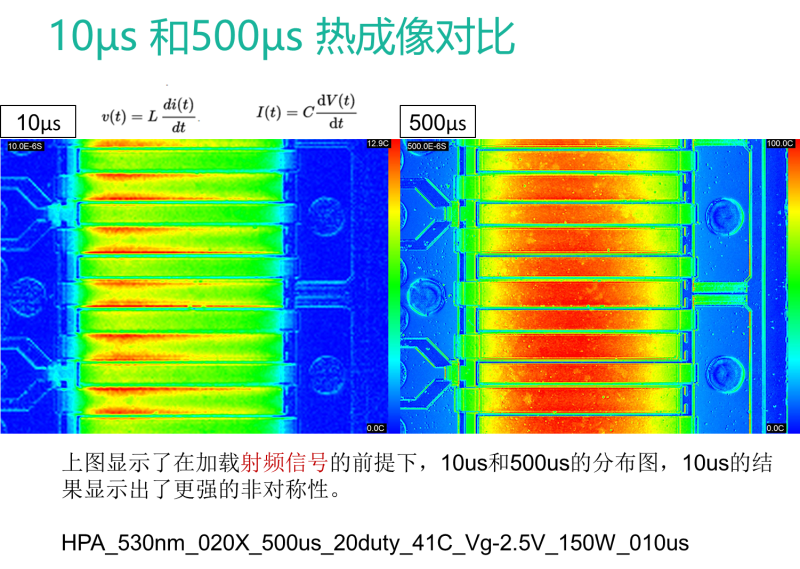
3、 光电子器件
(1)、InP 激光器测试
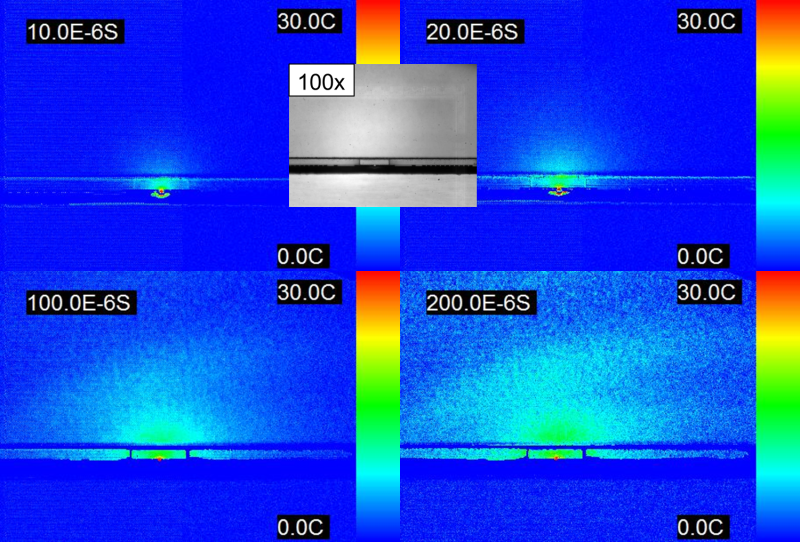
(2)、Ge/Si p-i-n 波导光电二极管测试
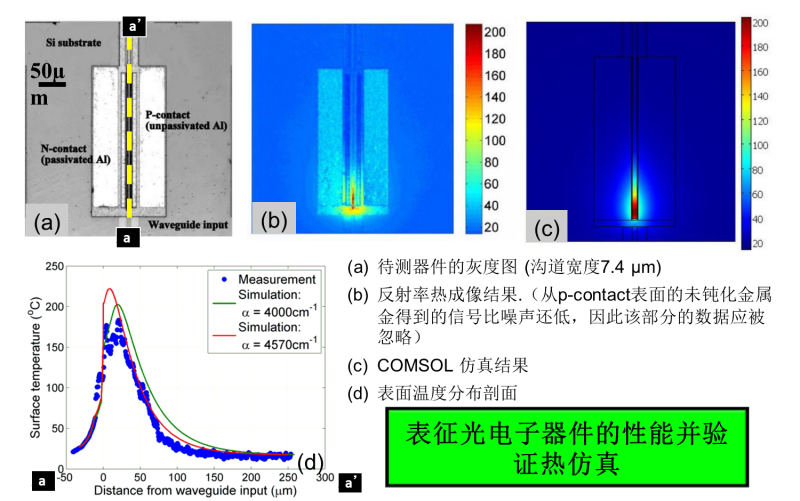
(3)、 研究太阳能电池背面由于划片槽引起的缺陷
该案例是利用SanjSCOPETM热成像系统反射率热成像系统研究太阳能电池表面由于划痕引起的漏电缺陷。
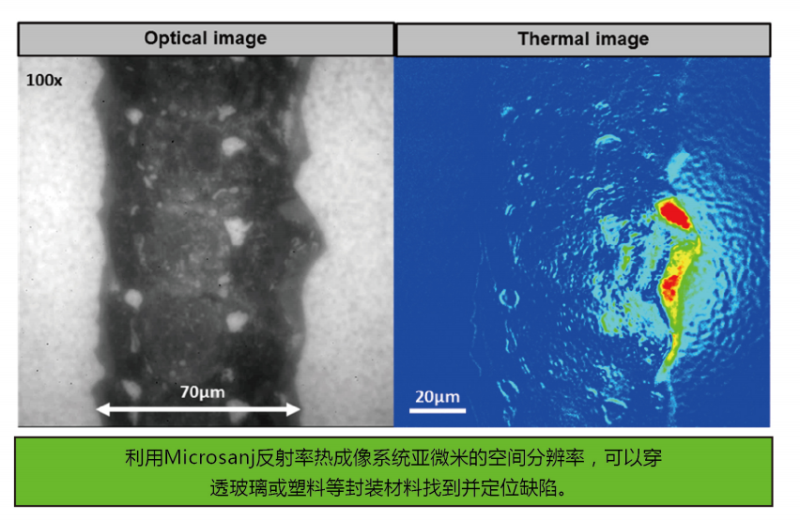
(4)、非破坏性测试封装LED的芯片表面温度分布
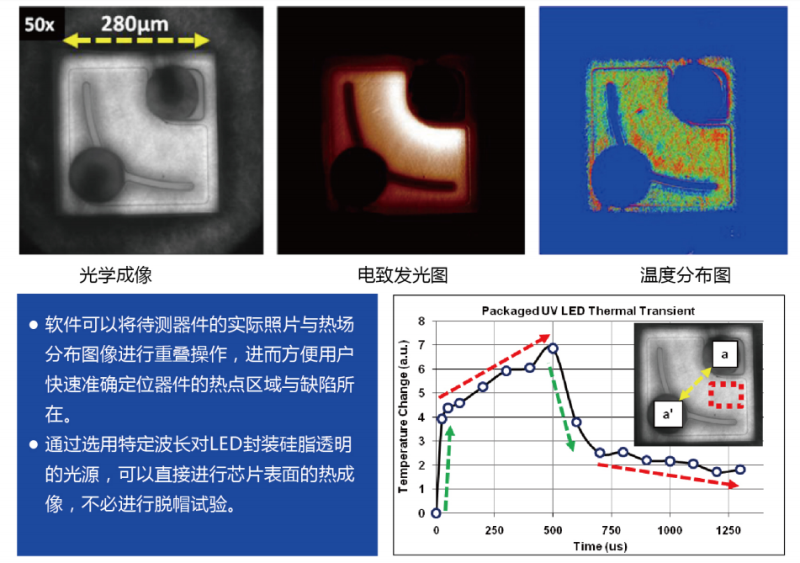
(5)、激光器测试
A、使用530nm,在5X物镜下的稳态测试结果(电流200mA,基板温度25℃)
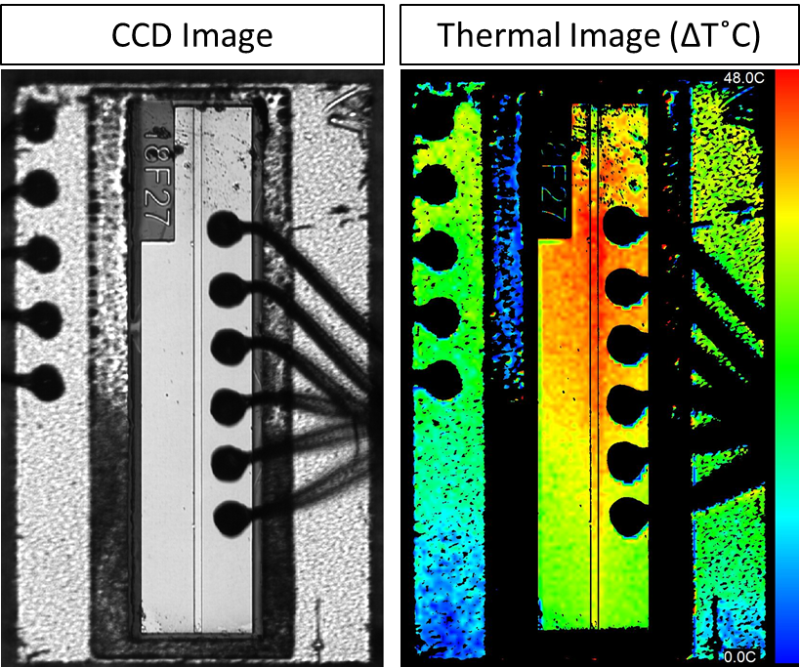


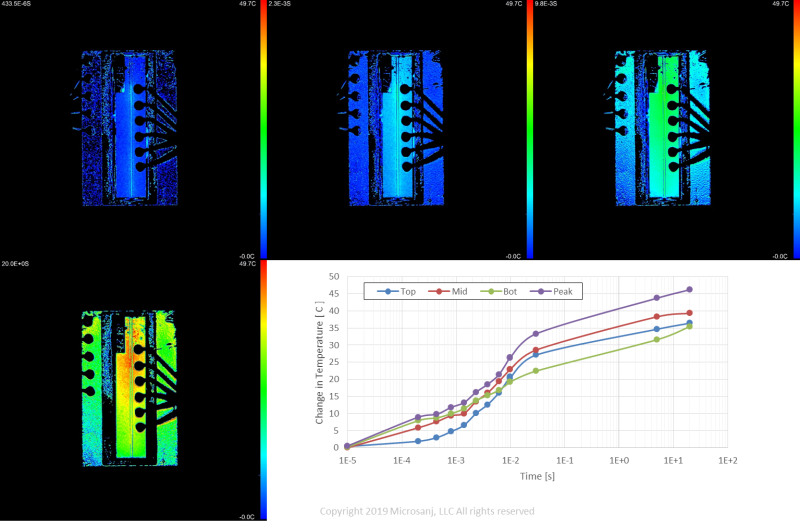
6、ESD静电保护器件
(1)、某ESD器件的瞬态热成像过程
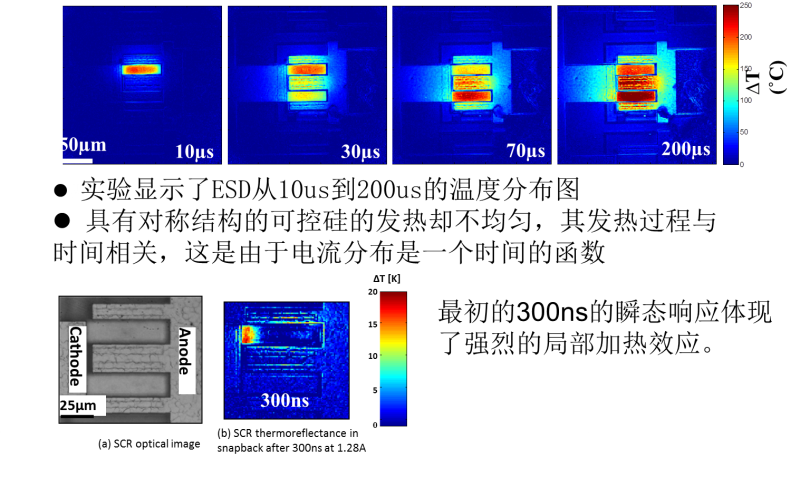
4、 热点探测
(1)、某样品的热点探测
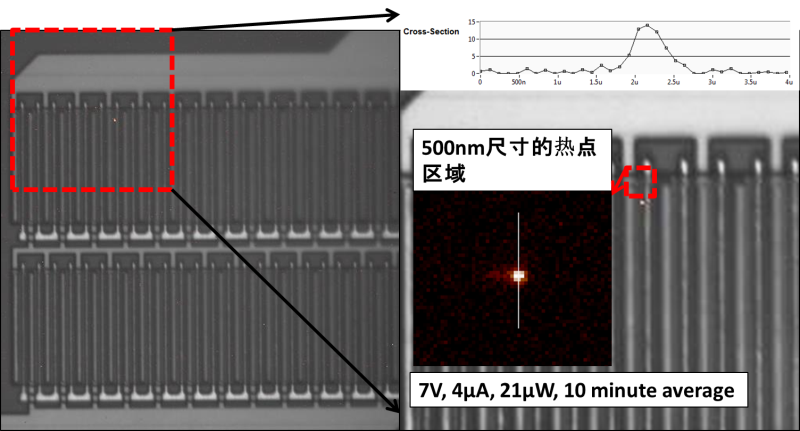
(2)、MOSFET栅极金属的热点探测
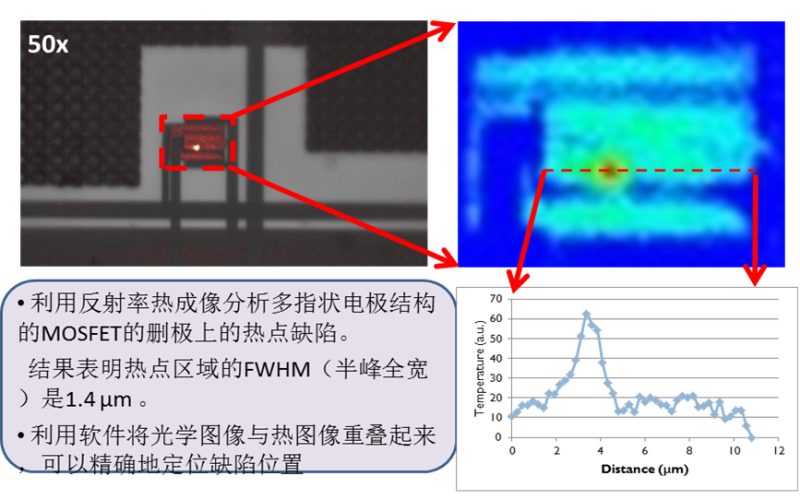
(3)、GaN HEMT故障分析
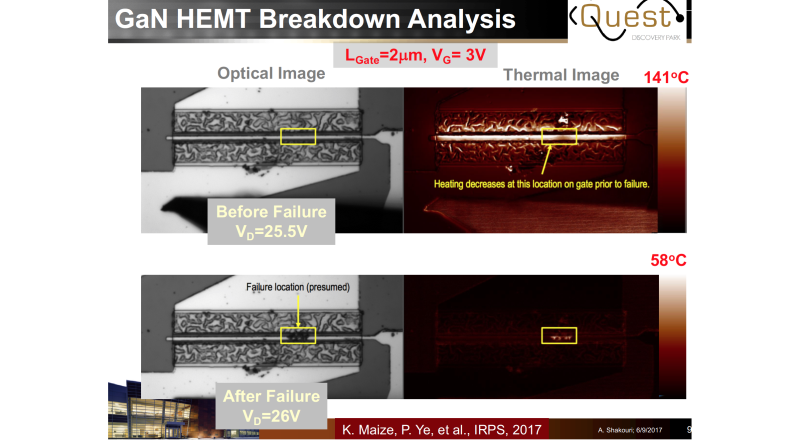
五、 MOSFET器件
在MOSFET器件中增加纳米线结构,有助于提高MOSFET的性能,但同时也增加了热管理上的挑战
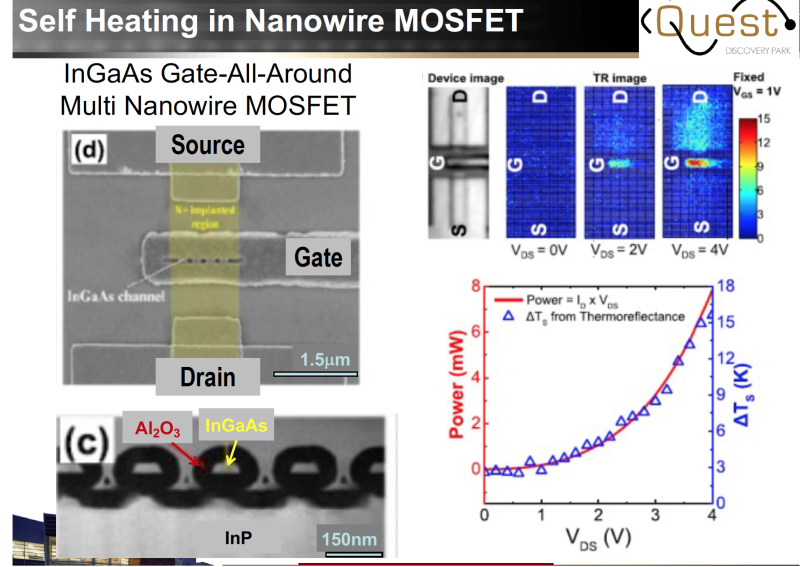
六、 研究IGBT的current filament现象
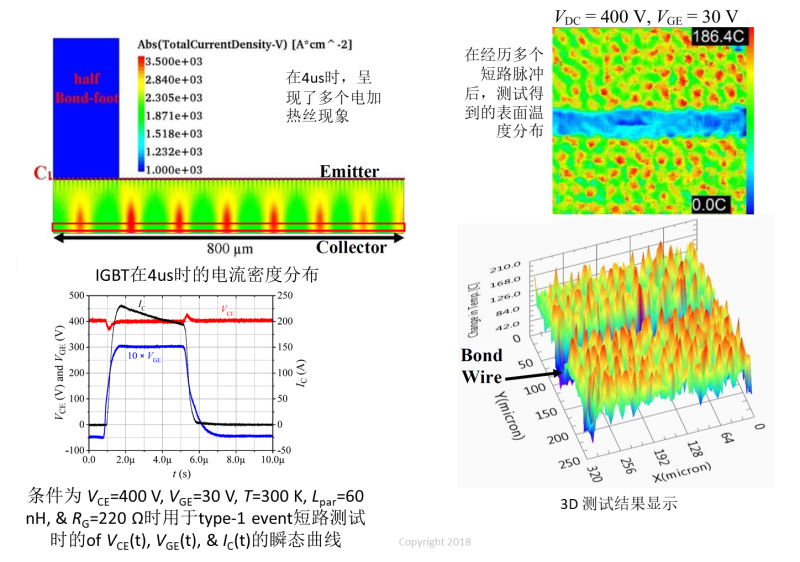
不同VDC, VGE值下,经过多个短路脉冲后的温度成像图
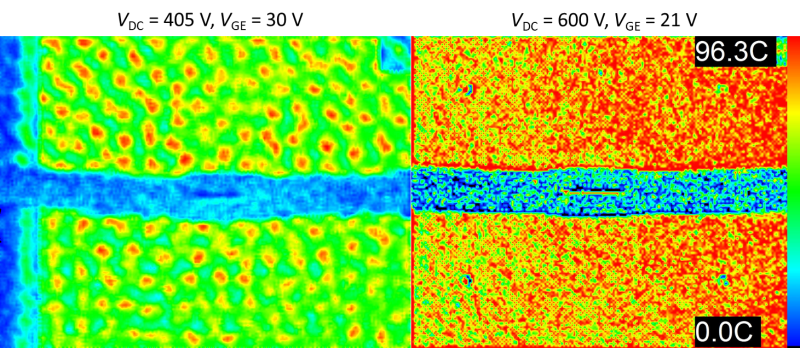
七、 IC测试
(1)、对某IC的闩锁进行瞬态测试
§ 通过与IC的启动序列进行同步,瞬态温度图可以显示功率循环的不同阶段
§ 对于具有高耗散功率以及差散热的器件,可以使用低占空比来限制整体加热。这样可以防止对器件引起只会在直流偏压下造成的破坏。
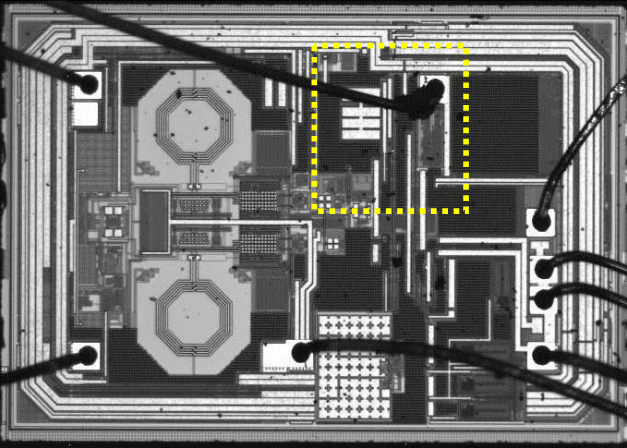
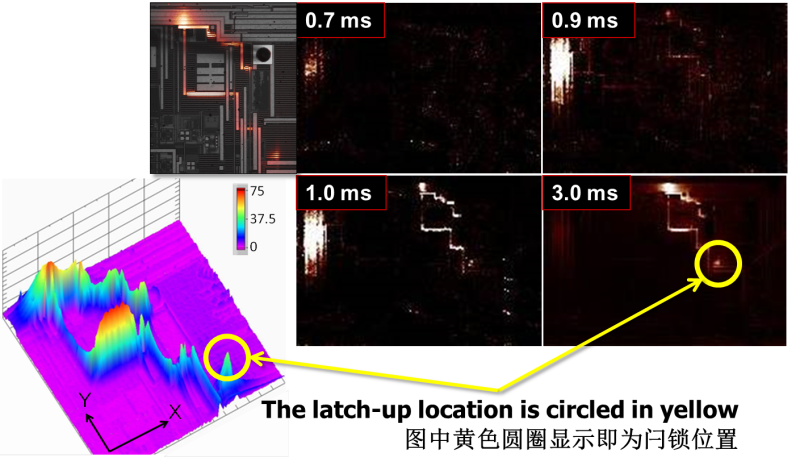
(2)、检查IC中 Interconnect 与 Via 的完整性
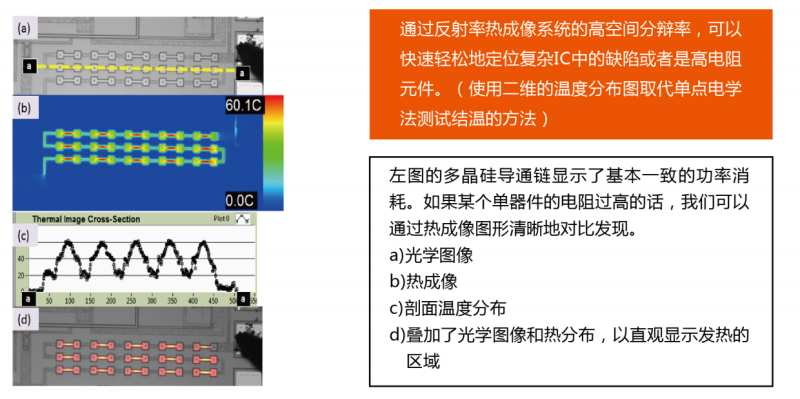
学术背景介绍
SanjSCOPE反射率热成像系统的研发者Dr. Ali Shakouri是美国加州理工大学博士,是公认的纳米技术领域的权威,曾担任加州大学圣克鲁兹分校电子工程系担任教授,目前任职普渡大学Birck纳米技术中心的主任。
SanjSCOPE提供了目前最高分辨率的热成像解决方案,该方法可以用于纳米级电子器件、光电子器件的热设计、热测试,进而用于分析缺陷,进行可靠性测试等。
美国空军研究实验室利用SanjSCOPE反射率热成像系统研究GaN HEMT器件的热特性
部分客户名单
商业客户
• 清华大学
• 复旦大学
• 西安电子科技大学
• 北京航空航天大学杭州创新研究院
• 上海大学
• 华为技术有限公司
• 中国电子技术标准化研究院 (电子四院)
• 中国电子产品可靠性与环境试验研究所 (电子五所)
• 季华实验室
• 三安集成电路
• 中科院西安光机所
• Intel Corporation 英特尔
• Apple 苹果
• Qualcomm 高通
• Raytheon 雷神
• Analog Devices 模拟器件
• Air Force Research Lab
• Radiant Optronics Pte Ltd
• Protochips, Inc.
• ATN Japan
• Western Digital
• Infinera
• Silicon Image
• MaCOM Ireland
• Mellanox-Kotura
• Georgia Tech
• Test Asia Equipments Pte Ltd
• Design Engineering Inc. (DEI)
• Chip Test Solutions
• BSW Test Systems AG
• 三安集成电路
大学及科研机构
• Birck Nanotechnology Center
• University of Cincinnati
• Penn State University
• University of Surrey
• 加州大学伯克利分校
• National University of Singapore
• Instituto de Microelectronica de Barcelona
• University of California at Santa Barbara
• Nanyang Technological University of Singapore
• Air Force Research Lab
• 中科院西安光机所
合作研究机构
• Agilent Technologies
• Sharp
• Altera Corporation
• Silicon Frontline
• A*Star Singapore
• SimTech
• CNES
• Si-Ware Systems
• ESA
• Stanford University
• Georgia Tech
• ST Microelectronics
• Maxim Integrated
• Texas Instruments (National Semiconductor)
• Nvidia
• Thales
• OnSemi
• Thermal Engineering Associates
• Package Science Services
• University of California at Santa Cruz
• Philips Electronics
• Wavetek
• Purdue University










.png)
.png)
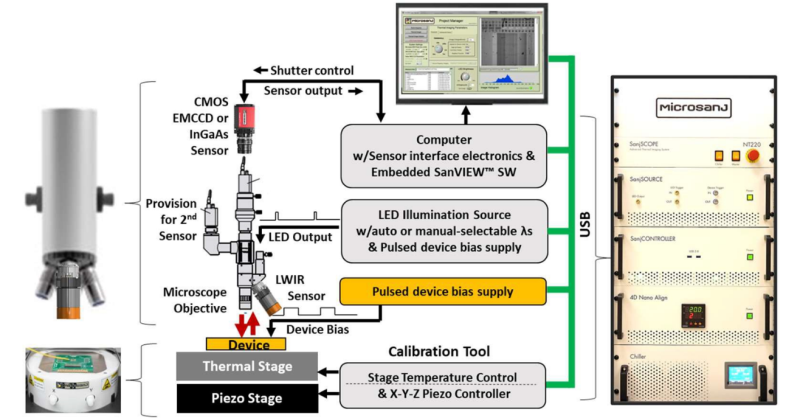
 沪公网安备 31010602003953号
沪公网安备 31010602003953号